Kod QR

Tentang Kami
Produk
Hubungi Kami


Faks
+86-579-87223657

E-mel

Alamat
Jalan Wangda, Jalan Ziyang, Kaunti Wuyi, Bandar Jinhua, Wilayah Zhejiang, China
Etsateknologi adalah salah satu langkah utama dalam proses pembuatan semikonduktor, yang digunakan untuk mengeluarkan bahan tertentu dari wafer untuk membentuk corak litar. Walau bagaimanapun, semasa proses etsa kering, jurutera sering menghadapi masalah seperti kesan pemuatan, kesan alur mikro dan kesan pengecasan, yang secara langsung menjejaskan kualiti dan prestasi produk akhir.
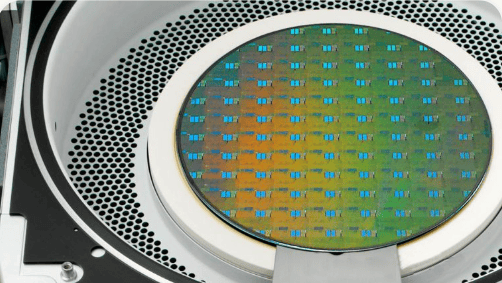
Kesan pemuatan merujuk kepada fenomena apabila kawasan goresan meningkat atau kedalaman goresan meningkat semasa goresan kering, kadar goresan berkurangan atau goresan tidak sekata kerana bekalan plasma reaktif yang tidak mencukupi. Kesan ini biasanya berkaitan dengan ciri-ciri sistem etsa, seperti ketumpatan dan keseragaman plasma, tahap vakum, dan lain-lain, dan terdapat secara meluas dalam pelbagai etsa ion reaktif.
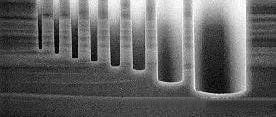
•Meningkatkan ketumpatan plasma dan keseragaman: Dengan mengoptimumkan reka bentuk sumber plasma, seperti menggunakan kuasa RF yang lebih cekap atau teknologi sputtering magnetron, ketumpatan yang lebih tinggi dan plasma yang lebih seragam boleh dihasilkan.
•Laraskan komposisi gas reaktif: Menambah jumlah gas tambahan yang sesuai untuk gas reaktif dapat meningkatkan keseragaman plasma dan menggalakkan pelepasan produk sampingan yang berkesan.
•Optimumkan sistem vakum: Meningkatkan kelajuan pengepaman dan kecekapan pam vakum boleh membantu mengurangkan masa tinggal produk sampingan etsa di dalam ruang, dengan itu mengurangkan kesan beban.
•Reka bentuk susun atur fotolitografi yang munasabah: Apabila mereka bentuk susun atur fotolitografi, ketumpatan corak harus diambil kira untuk mengelakkan susunan yang terlalu padat di kawasan tempatan untuk mengurangkan kesan kesan beban.
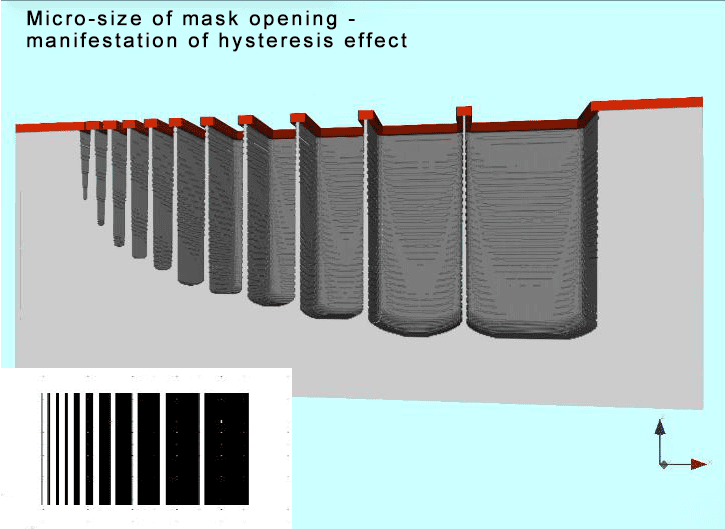
Kesan perangkap mikro merujuk kepada fenomena yang semasa proses etsa, disebabkan oleh zarah-zarah tenaga tinggi yang memukul permukaan etsa pada sudut cenderung, kadar etsa berhampiran dinding sisi lebih tinggi daripada yang di kawasan pusat, mengakibatkan tidak -Terical Chamfers di dinding sisi. Fenomena ini berkait rapat dengan sudut zarah kejadian dan cerun dinding sisi.
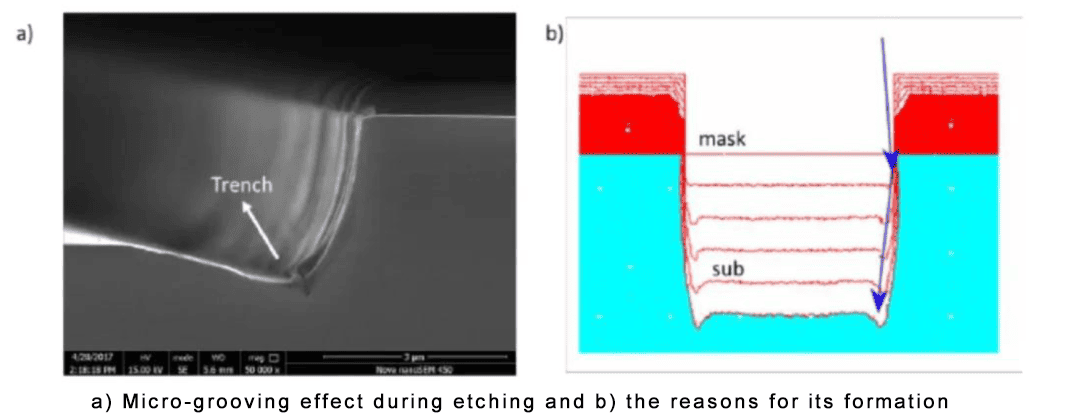
•Tingkatkan kuasa RF: Meningkatkan kuasa RF dengan betul dapat meningkatkan tenaga zarah insiden, yang membolehkan mereka membombardir permukaan sasaran lebih menegak, dengan itu mengurangkan perbezaan kadar etsa dinding sampingan.
•Pilih bahan topeng etsa yang betul: Sesetengah bahan boleh menentang kesan pengecasan dan mengurangkan kesan mikro-perangkap yang diperburuk oleh pengumpulan caj negatif pada topeng.
•Mengoptimumkan keadaan etsa: Dengan menyesuaikan parameter seperti suhu dan tekanan semasa proses etsa, selektiviti dan keseragaman etsa dapat dikawal dengan berkesan.
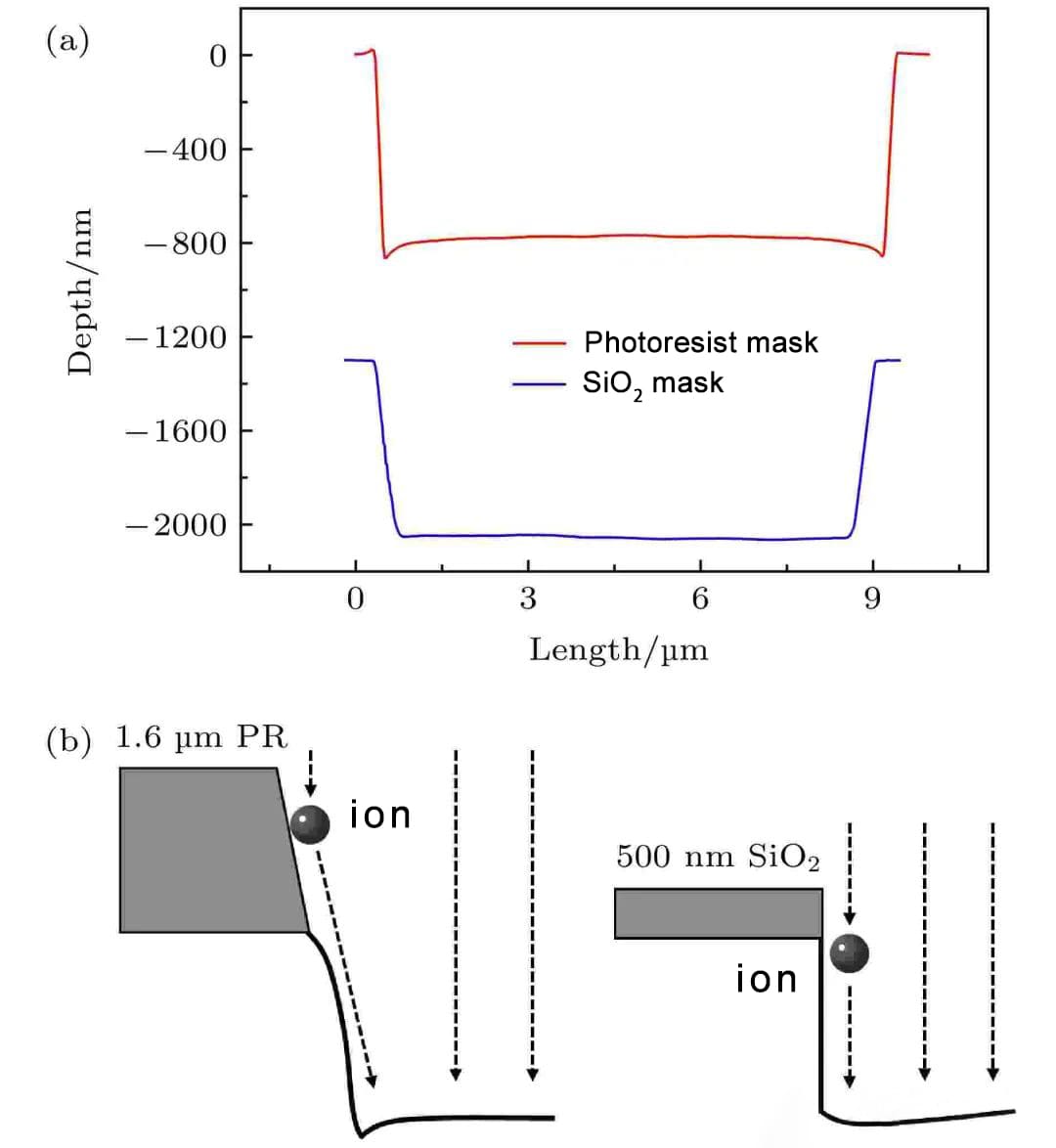
Kesan pengecasan disebabkan oleh sifat penebat topeng etsa. Apabila elektron dalam plasma tidak dapat melarikan diri dengan cepat, mereka akan berkumpul di permukaan topeng untuk membentuk medan elektrik tempatan, mengganggu jalan zarah kejadian, dan menjejaskan anisotropi etsa, terutamanya apabila menetap struktur halus.
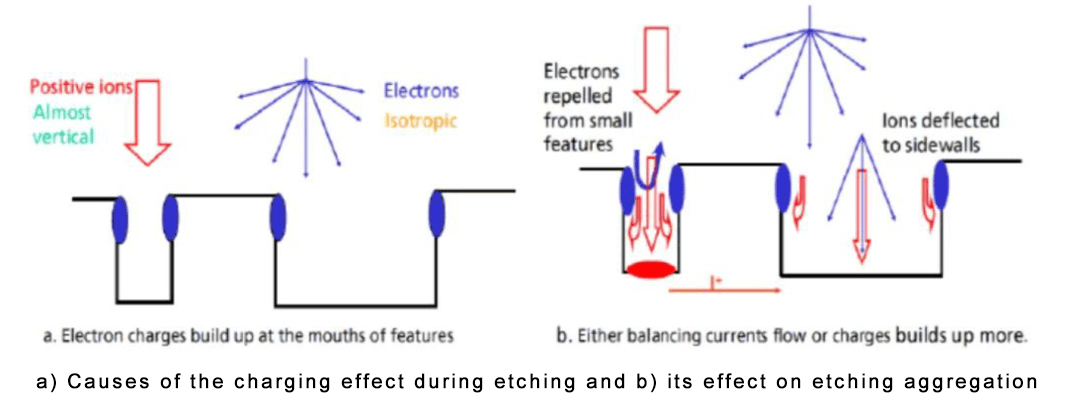
• Pilih bahan topeng etching yang sesuai: Beberapa bahan yang dirawat khas atau lapisan topeng konduktif dapat mengurangkan pengagregatan elektron.
•Laksanakan goresan sekejap-sekejap: Dengan mengganggu proses etsa secara berkala dan memberi elektron masa yang cukup untuk melarikan diri, kesan pengecasan boleh dikurangkan dengan ketara.
•Laraskan persekitaran etsa: Menukar komposisi gas, tekanan dan keadaan lain dalam persekitaran etsa dapat membantu meningkatkan kestabilan plasma dan mengurangkan terjadinya kesan pengecasan.
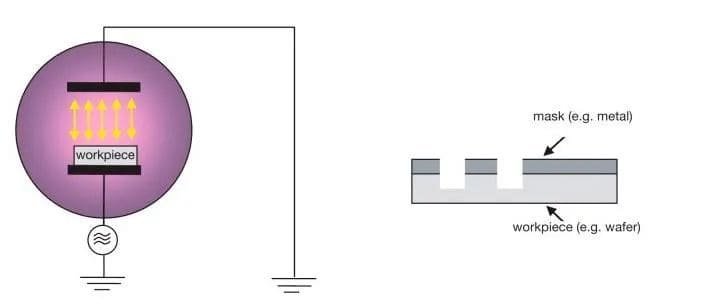



+86-579-87223657


Jalan Wangda, Jalan Ziyang, Kaunti Wuyi, Bandar Jinhua, Wilayah Zhejiang, China
Hak Cipta © 2024 WuYi TianYao Advanced Material Tech.Co.,Ltd. Hak Cipta Terpelihara.
Links | Sitemap | RSS | XML | Dasar Privasi |
