Kod QR

Tentang Kami
Produk
Hubungi Kami


Faks
+86-579-87223657

E-mel

Alamat
Jalan Wangda, Jalan Ziyang, Kaunti Wuyi, Bandar Jinhua, Wilayah Zhejiang, China
Substrat karbida silikon mempunyai banyak kecacatan dan tidak dapat diproses secara langsung. Filem nipis kristal tunggal tertentu perlu ditanam di atasnya melalui proses epitaxial untuk membuat wafer cip. Filem nipis ini adalah lapisan epitaxial. Hampir semua peranti karbida silikon direalisasikan pada bahan epitaxial. Bahan epitaxial silikon berkualiti tinggi adalah asas bagi pembangunan peranti silikon karbida. Prestasi bahan epitaxial secara langsung menentukan realisasi prestasi peranti silikon karbida.
Peranti karbida silikon yang tinggi dan tinggi-kebolehpercayaan telah mengemukakan keperluan yang lebih ketat pada morfologi permukaan, ketumpatan kecacatan, keseragaman doping dan ketebalan bahan epitaxial. Ketumpatan saiz besar, kekurangan rendah dan keseragaman tinggiSilicon Carbide Epitaxytelah menjadi kunci kepada pembangunan industri silikon karbida.
Penyediaan berkualiti tinggiSilicon Carbide EpitaxyMemerlukan proses dan peralatan lanjutan. Kaedah pertumbuhan epitaxial silikon karbida yang paling banyak digunakan ialah pemendapan wap kimia (CVD), yang mempunyai kelebihan kawalan ketebalan filem epitaxial dan kepekatan doping, kecacatan yang lebih sedikit, kadar pertumbuhan sederhana, dan kawalan proses automatik. Ia adalah teknologi yang boleh dipercayai yang telah berjaya dikomersialkan.
Silicon Carbide CVD Epitaxy umumnya menggunakan dinding panas atau peralatan CVD dinding panas, yang memastikan kesinambungan lapisan epitaxial 4H kristal sic di bawah keadaan suhu pertumbuhan yang lebih tinggi (1500-1700 ℃). Selepas bertahun -tahun pembangunan, dinding panas atau CVD dinding hangat boleh dibahagikan kepada reaktor struktur mendatar mendatar dan reaktor struktur menegak menegak mengikut hubungan antara arah aliran gas masuk dan permukaan substrat.
Kualiti relau epitaxial karbida silikon terutamanya mempunyai tiga petunjuk. Yang pertama ialah prestasi pertumbuhan epitaxial, termasuk keseragaman ketebalan, keseragaman doping, kadar kecacatan dan kadar pertumbuhan; Yang kedua ialah prestasi suhu peralatan itu sendiri, termasuk kadar pemanasan/penyejukan, suhu maksimum, keseragaman suhu; dan akhirnya prestasi kos peralatan itu sendiri, termasuk harga unit dan kapasiti pengeluaran.
CVD mendatar dinding panas, CVD planet dinding panas dan CVD menegak dinding-panas adalah penyelesaian teknologi peralatan epitaxial arus perdana yang telah digunakan secara komersil pada peringkat ini. Tiga peralatan teknikal juga mempunyai ciri -ciri mereka sendiri dan boleh dipilih mengikut keperluan. Rajah struktur ditunjukkan dalam gambar di bawah:

Sistem CVD mendatar dinding panas biasanya satu sistem pertumbuhan bersaiz besar yang didorong oleh pengapungan udara dan putaran. Adalah mudah untuk mencapai petunjuk yang baik. Model perwakilan adalah PE1O6 dari LPE Company di Itali. Mesin ini dapat merealisasikan pemuatan dan pemunggahan wafer automatik pada 900 ℃. Ciri -ciri utama adalah kadar pertumbuhan yang tinggi, kitaran epitaxial pendek, konsistensi yang baik dalam wafer dan antara relau, dan lain -lain. Ia mempunyai bahagian pasaran tertinggi di China.

Menurut laporan rasmi LPE, digabungkan dengan penggunaan pengguna utama, 100-150mm (4-6 inci) 4H-SIC epitaxial wafer produk dengan ketebalan kurang daripada 30μm yang dihasilkan oleh relau epitaxial yang tidak dapat dicapai oleh penunjuk-umbi-kekosit yang tidak stabil. ≤5%, ketumpatan kecacatan permukaan ≤1cm-2, kawasan bebas kecacatan permukaan (sel 2mm × 2mm) ≥90%.
Syarikat-syarikat domestik seperti JSG, CETC 48, Naura, dan NASO telah membangunkan peralatan epitaxial silikon karbida monolitik dengan fungsi yang sama dan telah mencapai penghantaran berskala besar. Sebagai contoh, pada bulan Februari 2023, JSG mengeluarkan peralatan epitaxial SIC dua inci. Peralatan menggunakan lapisan atas dan bawah lapisan atas dan bawah bahagian grafit ruang tindak balas untuk menanam dua wafer epitaxial dalam relau tunggal, dan gas proses atas dan bawah boleh dikawal secara berasingan, dengan perbezaan suhu ≤5 ° C, yang secara berkesan membentuk untuk merugikan.Bahagian separuh salutan sic. Kami membekalkan 6 inci dan 8 inci separuh bahagian kepada pengguna.

Sistem CVD planet dinding hangat, dengan susunan planet asas, dicirikan oleh pertumbuhan wafer berganda dalam relau tunggal dan kecekapan output yang tinggi. Model perwakilan adalah AIXG5WWC (8x150mm) dan G10-SIC (9 × 150mm atau 6 × 200mm) peralatan epitaxial dari Aixtron dari Jerman.
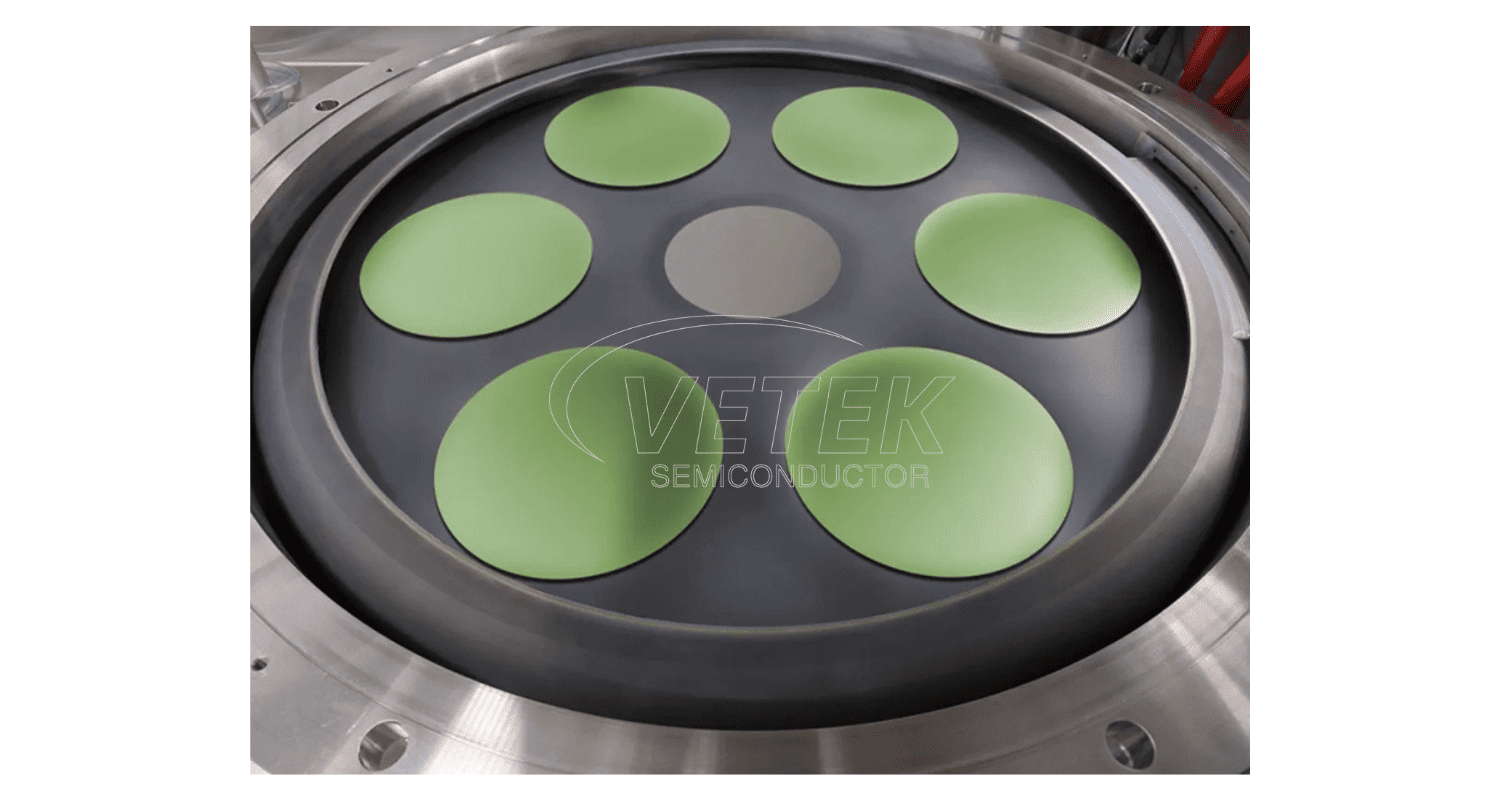
Menurut laporan rasmi Aixtron, produk wafer epitaxial 4H-SIC 6-inci dengan ketebalan 10μm yang dihasilkan oleh relau epitaxial G10 dapat mencapai penunjuk berikut: sisihan ketebalan epitaxial interfer. doping kepekatan tidak seragam <2%.
Sehingga sekarang, model jenis ini jarang digunakan oleh pengguna domestik, dan data pengeluaran batch tidak mencukupi, yang pada tahap tertentu mengehadkan permohonan kejuruteraannya. Di samping itu, disebabkan oleh halangan teknikal yang tinggi dari relau epitaxial multi-wafer dari segi medan suhu dan kawalan medan aliran, perkembangan peralatan domestik yang sama masih dalam peringkat penyelidikan dan pembangunan, dan tidak ada model alternatif.
Sistem CVD menegak hampir-panas-dinding terutamanya berputar pada kelajuan tinggi melalui bantuan mekanikal luaran. Ciri -cirinya adalah bahawa ketebalan lapisan likat secara berkesan dikurangkan oleh tekanan ruang tindak balas yang lebih rendah, dengan itu meningkatkan kadar pertumbuhan epitaxial. Pada masa yang sama, ruang reaksinya tidak mempunyai dinding atas di mana zarah -zarah SIC boleh didepositkan, dan tidak mudah untuk menghasilkan objek yang jatuh. Ia mempunyai kelebihan yang wujud dalam kawalan kecacatan. Model perwakilan adalah relau epitaxial tunggal Epirevos6 dan Epirevos8 dari Nuflare Jepun.
Menurut Nuflare, kadar pertumbuhan peranti Epirevos6 dapat mencapai lebih dari 50μm/j, dan ketumpatan kecacatan permukaan wafer epitaxial dapat dikawal di bawah 0.1cm-²; Dari segi kawalan keseragaman, jurutera Nuflare Yoshiaki Daigo melaporkan hasil keseragaman intra-wafer dari 10 μm tebal 6-inci wafer yang ditanam menggunakan EpireVos6, dan ketebalan intra-wafer dan doping kepekatan tidak mencapai 1%Silinder grafit atas.
Pada masa ini, pengeluar peralatan domestik seperti generasi ketiga teras dan JSG telah merancang dan melancarkan peralatan epitaxial dengan fungsi yang sama, tetapi mereka tidak digunakan secara besar -besaran.
Secara umum, tiga jenis peralatan mempunyai ciri -ciri mereka sendiri dan menduduki bahagian pasaran tertentu dalam keperluan aplikasi yang berbeza:
Struktur CVD mendatar dinding panas mempunyai kadar pertumbuhan ultra cepat, kualiti dan keseragaman, operasi dan penyelenggaraan peralatan mudah, dan aplikasi pengeluaran besar-besaran yang matang. Walau bagaimanapun, disebabkan oleh jenis tunggal dan penyelenggaraan yang kerap, kecekapan pengeluaran adalah rendah; CVD planet dinding yang hangat umumnya mengamalkan 6 (sekeping) × 100 mm (4 inci) atau 8 (sekeping) × 150 mm (6 inci) struktur dulang, yang sangat meningkatkan kecekapan pengeluaran peralatan dari segi kapasiti pengeluaran, tetapi sukar untuk mengawal konsistensi pelbagai keping, dan hasil pengeluaran masih menjadi masalah terbesar; CVD menegak dinding panas-panas mempunyai struktur yang kompleks, dan kawalan kecacatan kualiti pengeluaran wafer epitaxial sangat baik, yang memerlukan pengalaman penyelenggaraan dan penggunaan peralatan yang sangat kaya.
Kadar pertumbuhan yang cepat
Mudah struktur peralatan dan
penyelenggaraan yang mudah
Kapasiti pengeluaran yang besar
kecekapan pengeluaran yang tinggi
Kawalan kecacatan produk yang baik
ruang reaksi panjang
kitaran penyelenggaraan
Struktur kompleks
sukar dikawal
konsistensi produk
Struktur peralatan kompleks,
penyelenggaraan yang sukar
Wakil
peralatan
pengeluar
CVD mendatar dinding panas
Cwd planet dinding hangat
CTD menegak dinding kuasi-panas
Kelebihan
Kekurangan
Kitaran penyelenggaraan pendek
Itali LPE, Jepun Tel
Jerman Aixtron
Jepun nuflare
Dengan perkembangan industri yang berterusan, ketiga -tiga jenis peralatan ini akan dioptimumkan dan dinaik taraf dari segi struktur, dan konfigurasi peralatan akan menjadi lebih sempurna, memainkan peranan penting dalam memadankan spesifikasi wafer epitaxial dengan ketebalan dan keperluan kecacatan yang berbeza.



+86-579-87223657


Jalan Wangda, Jalan Ziyang, Kaunti Wuyi, Bandar Jinhua, Wilayah Zhejiang, China
Hak Cipta © 2024 WuYi TianYao Advanced Material Tech.Co.,Ltd. Hak Cipta Terpelihara.
Links | Sitemap | RSS | XML | Dasar Privasi |
