Kod QR

Tentang Kami
Produk
Hubungi Kami


Faks
+86-579-87223657

E-mel

Alamat
Jalan Wangda, Jalan Ziyang, Kaunti Wuyi, Bandar Jinhua, Wilayah Zhejiang, China
Kaedah utama untuk berkembang kristal tunggal SIC adalah:Pengangkutan Wap Fizikal (PVT), Pemendapan wap kimia suhu tinggi (HTCVD)danPertumbuhan Penyelesaian Suhu Tinggi (HTSG). Seperti yang ditunjukkan dalam Rajah 1. Di antara mereka, kaedah PVT adalah kaedah yang paling matang dan digunakan secara meluas pada tahap ini. Pada masa ini, substrat kristal tunggal 6-inci telah dimusnahkan, dan kristal tunggal 8 inci juga telah berjaya ditanam oleh Cree di Amerika Syarikat pada tahun 2016. Namun, kaedah ini mempunyai batasan seperti ketumpatan kecacatan yang tinggi, hasil yang rendah, pengembangan diameter yang sukar, dan kos yang tinggi.
Kaedah HTCVD menggunakan prinsip bahawa sumber Si dan C sumber re bertindak balas secara kimia untuk menghasilkan SIC dalam persekitaran suhu tinggi kira -kira 2100 ℃ untuk mencapai pertumbuhan kristal tunggal SIC. Seperti kaedah PVT, kaedah ini juga memerlukan suhu pertumbuhan yang tinggi dan mempunyai kos pertumbuhan yang tinggi. Kaedah HTSG adalah berbeza daripada dua kaedah di atas. Prinsip asasnya adalah menggunakan pembubaran dan reprekipitasi elemen Si dan C dalam penyelesaian suhu tinggi untuk mencapai pertumbuhan kristal tunggal SIC. Model teknikal yang digunakan secara meluas adalah kaedah TSSG.
Kaedah ini dapat mencapai pertumbuhan SIC dalam keadaan keseimbangan dekat-termodinamik pada suhu yang lebih rendah (di bawah 2000 ° C), dan kristal berkembang mempunyai kelebihan berkualiti tinggi, kos rendah, pengembangan diameter mudah, dan doping p-jenis yang stabil. Ia dijangka menjadi kaedah untuk menyediakan kristal tunggal SIC yang lebih besar, berkualiti tinggi dan lebih rendah selepas kaedah PVT.
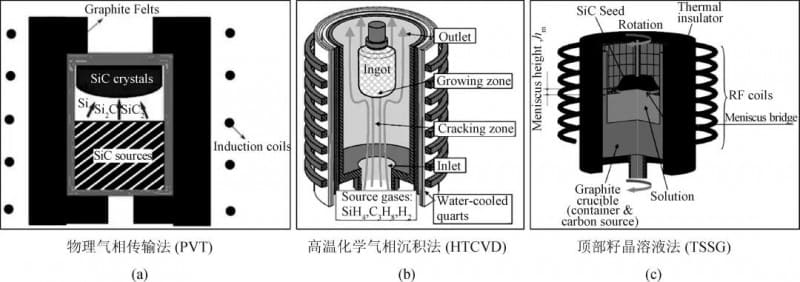
Rajah 1. Skematik gambarajah prinsip tiga teknologi pertumbuhan kristal tunggal
Kaedah HTSG untuk SIC yang semakin meningkat mempunyai sejarah lebih daripada 60 tahun.
Pada tahun 1961, Halden et al. Mula-mula memperoleh kristal tunggal SIC dari cair Si suhu tinggi di mana C dibubarkan, dan kemudian meneroka pertumbuhan kristal tunggal SIC dari penyelesaian suhu tinggi yang terdiri daripada Si+X (di mana X adalah satu atau lebih unsur-unsur Fe, Cr, Sc, Tb, PR, dan lain-lain).
Pada tahun 1999, Hofmann et al. Dari University of Erlangen di Jerman menggunakan Si Pure sebagai fluks diri dan menggunakan kaedah TSSG suhu tinggi dan tekanan tinggi untuk mengembangkan kristal tunggal SIC dengan diameter 1.4 inci dan ketebalan kira-kira 1 mm untuk kali pertama.
Pada tahun 2000, mereka terus mengoptimumkan proses dan meningkatkan kristal SIC dengan diameter 20-30 mm dan ketebalan sehingga 20 mm menggunakan Si murni sebagai fluks diri dalam suasana tekanan tinggi 100-200 bar pada 1900-2400 ° C.
Sejak itu, penyelidik di Jepun, Korea Selatan, Perancis, China dan negara -negara lain telah menjalankan penyelidikan mengenai pertumbuhan substrat kristal tunggal SIC dengan kaedah TSSG, yang telah menjadikan kaedah TSSG berkembang pesat dalam beberapa tahun kebelakangan ini. Antaranya, Jepun diwakili oleh Sumitomo Metal dan Toyota. Jadual 1 dan Rajah 2 menunjukkan kemajuan penyelidikan logam Sumitomo dalam pertumbuhan kristal tunggal SIC, dan Jadual 2 dan Rajah 3 menunjukkan proses penyelidikan utama dan hasil wakil Toyota.
Pasukan penyelidikan ini mula menjalankan penyelidikan mengenai pertumbuhan kristal SIC dengan kaedah TSSG pada tahun 2016, dan berjaya memperoleh kristal 4H-SIC 2-inci dengan ketebalan 10 mm. Baru-baru ini, pasukan telah berjaya mengembangkan kristal 4H-SIC 4-inci, seperti yang ditunjukkan dalam Rajah 4.
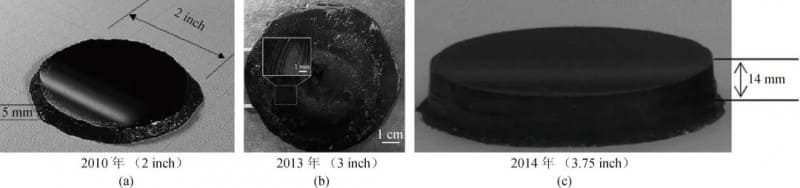
Rajah 2.Foto optik Sic Crystal yang ditanam oleh pasukan Sumitomo Metal menggunakan kaedah TSSG

Rajah 3.Pencapaian wakil pasukan Toyota dalam pertumbuhan kristal tunggal SIC menggunakan kaedah TSSG
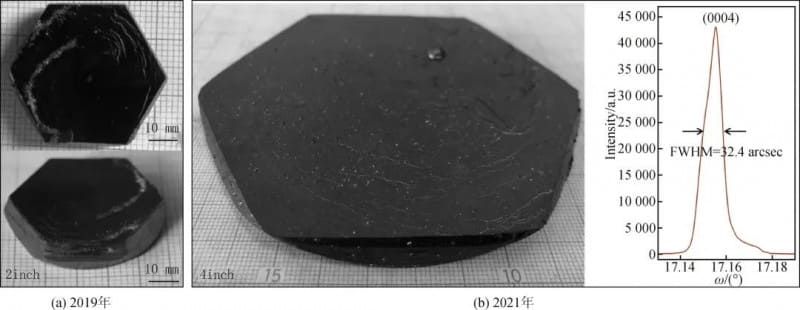
Rajah 4. Pencapaian Wakil Institut Fizik, Akademi Sains Cina, dalam Growing SIC Single Crystals menggunakan kaedah TSSG
SIC tidak mempunyai titik lebur pada tekanan normal. Apabila suhu mencapai di atas tahun 2000 ℃, ia akan secara langsung gasify dan terurai. Oleh itu, ia tidak boleh dilaksanakan untuk mengembangkan kristal tunggal dengan perlahan -lahan menyejukkan dan menguatkan cair sic komposisi yang sama, iaitu, kaedah mencairkan.
Menurut gambarajah fasa binari SI-C, terdapat rantau dua fasa "L+SIC" pada akhir SI-kaya, yang memberikan kemungkinan pertumbuhan fasa cecair SIC. Walau bagaimanapun, kelarutan Si tulen untuk C terlalu rendah, jadi perlu menambah fluks ke Si cair untuk membantu meningkatkan kepekatan C dalam larutan suhu tinggi. Pada masa ini, mod teknikal arus perdana untuk pertumbuhan kristal tunggal SIC dengan kaedah HTSG adalah kaedah TSSG. Rajah 5 (a) adalah gambarajah skematik prinsip kristal tunggal SIC yang semakin meningkat oleh kaedah TSSG.
Antaranya, peraturan sifat termodinamik penyelesaian suhu tinggi dan dinamik proses pengangkutan larut dan antara muka pertumbuhan kristal untuk mencapai keseimbangan dinamik bekalan dan permintaan solut C dalam keseluruhan sistem pertumbuhan adalah kunci untuk lebih baik merealisasikan pertumbuhan kristal tunggal SIC oleh kaedah TSSG.
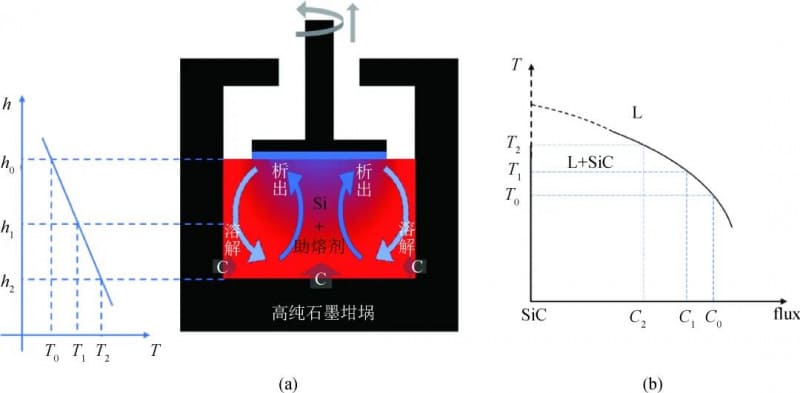
Rajah 5. (a) gambarajah skematik pertumbuhan kristal tunggal SIC oleh kaedah TSSG; (b) Rajah skematik bahagian membujur di rantau dua fasa L+SIC
Melarutkan C cukup C ke dalam penyelesaian suhu tinggi adalah kunci untuk berkembang kristal tunggal SIC dengan kaedah TSSG. Menambah elemen fluks adalah cara yang berkesan untuk meningkatkan kelarutan C dalam penyelesaian suhu tinggi.
Pada masa yang sama, penambahan unsur-unsur fluks juga akan mengawal ketumpatan, kelikatan, ketegangan permukaan, titik pembekuan dan parameter termodinamik lain penyelesaian suhu tinggi yang berkait rapat dengan pertumbuhan kristal, dengan itu secara langsung mempengaruhi proses termodinamik dan kinetik dalam pertumbuhan kristal. Oleh itu, pemilihan elemen fluks adalah langkah yang paling kritikal dalam mencapai kaedah TSSG untuk pertumbuhan kristal tunggal SIC dan merupakan tumpuan penyelidikan dalam bidang ini.
Terdapat banyak sistem penyelesaian suhu tinggi binari yang dilaporkan dalam kesusasteraan, termasuk Li-Si, Ti-Si, Cr-Si, Fe-Si, Sc-Si, Ni-Si dan Co-Si. Antaranya, sistem binari Cr-Si, Ti-Si dan Fe-Si dan sistem pelbagai komponen seperti Cr-ce-al-Si dibangunkan dengan baik dan telah memperoleh hasil pertumbuhan kristal yang baik.
Rajah 6 (a) menunjukkan hubungan antara kadar pertumbuhan dan suhu SIC dalam tiga sistem penyelesaian suhu tinggi yang berbeza Cr-Si, Ti-Si dan Fe-Si, diringkaskan oleh Kawanishi et al. Universiti Tohoku di Jepun pada tahun 2020.
Seperti yang ditunjukkan dalam Rajah 6 (b), Hyun et al. direka bentuk satu siri sistem penyelesaian suhu tinggi dengan nisbah komposisi SI0.56CR0.4M0.04 (M = SC, TI, V, CR, MN, FE, CO, NI, CU, RH dan PD) untuk menunjukkan kelarutan C.

Rajah 6. (a) Hubungan antara kadar pertumbuhan kristal tunggal dan suhu apabila menggunakan sistem penyelesaian suhu tinggi yang berbeza
Untuk mendapatkan kristal tunggal SIC berkualiti tinggi, ia juga perlu mengawal kinetik pemendakan kristal. Oleh itu, satu lagi fokus penyelidikan kaedah TSSG untuk pertumbuhan kristal tunggal SIC adalah peraturan kinetik dalam penyelesaian suhu tinggi dan pada antara muka pertumbuhan kristal.
Cara utama peraturan termasuk: putaran dan penarik proses kristal benih dan crucible, peraturan medan suhu dalam sistem pertumbuhan, pengoptimuman struktur dan saiz yang boleh dipenuhi, dan peraturan konveksi penyelesaian suhu tinggi oleh medan magnet luaran. Tujuan asas adalah untuk mengawal selia medan suhu, medan aliran dan medan kepekatan larut di antara muka antara larutan suhu tinggi dan pertumbuhan kristal, untuk mendesiskan SIC yang lebih baik dan lebih cepat dari larutan suhu tinggi dengan cara yang teratur dan berkembang menjadi kristal tunggal bersaiz besar yang berkualiti tinggi.
Penyelidik telah mencuba banyak kaedah untuk mencapai peraturan yang dinamik, seperti "teknologi putaran dipercepat yang dipercepatkan" yang digunakan oleh Kusunoki et al. Dalam kerja mereka yang dilaporkan pada tahun 2006, dan "teknologi pertumbuhan penyelesaian cekung" yang dibangunkan oleh Daikoku et al.
Pada tahun 2014, Kusunoki et al. Menambah struktur cincin grafit sebagai panduan rendaman (IG) dalam crucible untuk mencapai peraturan perolakan penyelesaian suhu tinggi. Dengan mengoptimumkan saiz dan kedudukan cincin grafit, mod pengangkutan larut ke atas boleh ditubuhkan dalam larutan suhu tinggi di bawah kristal benih, dengan itu meningkatkan kadar pertumbuhan dan kualiti kristal, seperti yang ditunjukkan dalam Rajah 7.

Rajah 7: (a) Keputusan simulasi aliran penyelesaian suhu tinggi dan pengagihan suhu dalam crucible;
(b) Rajah skematik peranti eksperimen dan ringkasan hasil
Kelebihan kaedah TSSG dalam pertumbuhan kristal tunggal SIC ditunjukkan dalam aspek berikut:
(1) Kaedah penyelesaian suhu tinggi untuk tumbuh kristal tunggal SIC dapat membaiki mikrotube dengan berkesan dan kecacatan makro lain dalam kristal benih, dengan itu meningkatkan kualiti kristal. Pada tahun 1999, Hofmann et al. Diperhatikan dan dibuktikan melalui mikroskop optik bahawa mikrotube dapat dilindungi dengan berkesan dalam proses kristal tunggal SIC yang semakin meningkat oleh kaedah TSSG, seperti yang ditunjukkan dalam Rajah 8.
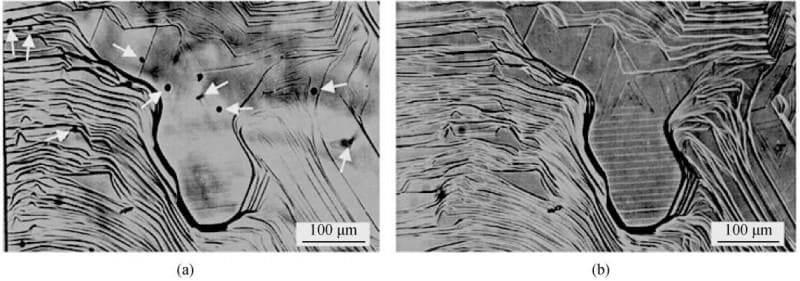
Rajah 8: Penghapusan mikrotube semasa pertumbuhan kristal tunggal SIC oleh kaedah TSSG:
(a) mikrograf optik kristal SIC yang ditanam oleh TSSG dalam mod penghantaran, di mana microtubes di bawah lapisan pertumbuhan dapat dilihat dengan jelas;
(b) Mikrograf optik kawasan yang sama dalam mod refleksi, menunjukkan bahawa microtubes telah dilindungi sepenuhnya.
(2) Berbanding dengan kaedah PVT, kaedah TSSG dapat dengan lebih mudah mencapai pengembangan diameter kristal, dengan itu meningkatkan diameter substrat kristal tunggal SIC, dengan berkesan meningkatkan kecekapan pengeluaran peranti SIC dan mengurangkan kos pengeluaran.
Pasukan penyelidikan yang berkaitan dengan Toyota dan Sumitomo Corporation telah berjaya mencapai pengembangan diameter kristal yang dapat dikawal secara buatan dengan menggunakan teknologi "kawalan ketinggian meniskus", seperti yang ditunjukkan dalam Rajah 9 (a) dan (b).
Rajah 9: (a) gambarajah skematik teknologi kawalan meniscus dalam kaedah TSSG;
(b) perubahan sudut pertumbuhan θ dengan ketinggian meniskus dan pandangan sampingan kristal SIC yang diperolehi oleh teknologi ini;
(c) pertumbuhan selama 20 jam pada ketinggian meniskus 2.5 mm;
(d) pertumbuhan selama 10 jam pada ketinggian meniskus 0.5 mm;
(e) Pertumbuhan selama 35 jam, dengan ketinggian meniskus secara beransur -ansur meningkat dari 1.5 mm ke nilai yang lebih besar.
(3) Berbanding dengan kaedah PVT, kaedah TSSG lebih mudah untuk mencapai doping p-jenis stabil kristal SIC. Sebagai contoh, Shirai et al. Toyota melaporkan pada tahun 2014 bahawa mereka telah berkembang dengan rintangan rendah p-jenis kristal 4H-SIC oleh kaedah TSSG, seperti yang ditunjukkan dalam Rajah 10.
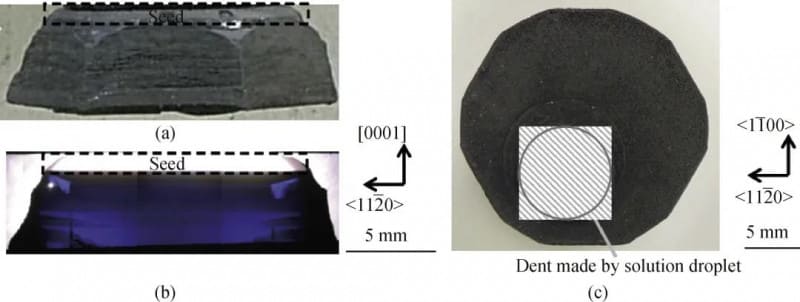
Rajah 10: (a) Pandangan sisi kristal tunggal p-jenis yang ditanam oleh kaedah TSSG;
(b) gambar optik penghantaran bahagian membujur kristal;
(c) morfologi permukaan atas kristal yang ditanam dari penyelesaian suhu tinggi dengan kandungan Al 3% (pecahan atom)
Kaedah TSSG untuk pertumbuhan kristal SIC telah membuat kemajuan besar dalam 20 tahun yang lalu, dan beberapa pasukan telah berkembang kristal tunggal 4-inci SIC yang berkualiti tinggi dengan kaedah TSSG.
Walau bagaimanapun, perkembangan selanjutnya teknologi ini masih memerlukan kejayaan dalam aspek utama berikut:
(1) kajian mendalam mengenai sifat termodinamik penyelesaian;
(2) keseimbangan antara kadar pertumbuhan dan kualiti kristal;
(3) penubuhan keadaan pertumbuhan kristal yang stabil;
(4) Pembangunan teknologi kawalan dinamik yang halus.
Walaupun kaedah TSSG masih agak di belakang kaedah PVT, dipercayai bahawa dengan usaha berterusan para penyelidik dalam bidang ini, kerana masalah saintifik utama yang semakin meningkat kristal tunggal oleh kaedah TSSG secara berterusan diselesaikan dan teknologi utama dalam proses yang berlarutan, dengan itu akan menjadi lebih baik, dengan itu akan menjadi lebih baik, dengan itu akan menjadi lebih baik untuk memainkan peranan yang besar untuk memberi goreng kepada Pembangunan industri SIC.



+86-579-87223657


Jalan Wangda, Jalan Ziyang, Kaunti Wuyi, Bandar Jinhua, Wilayah Zhejiang, China
Hak Cipta © 2024 WuYi TianYao Advanced Material Tech.Co.,Ltd. Hak Cipta Terpelihara.
Links | Sitemap | RSS | XML | Dasar Privasi |
