Kod QR

Tentang Kami
Produk
Hubungi Kami


Faks
+86-579-87223657

E-mel

Alamat
Jalan Wangda, Jalan Ziyang, Kaunti Wuyi, Bandar Jinhua, Wilayah Zhejiang, China
Dalam paparan panel semikonduktor dan FPD, penyediaan filem nipis adalah proses penting. Terdapat banyak cara untuk menyediakan filem nipis (TF, Filem Nipis), dua kaedah berikut adalah biasa:
● CVD (pemendapan wap kimia)
● PVD (Pemendapan Wap Fizikal)
Antaranya, lapisan penampan/lapisan aktif/lapisan penebat semuanya didepositkan di dalam ruang mesin menggunakan PECVD.
● Gunakan gas khas: SiH4/NH3/N2O untuk pemendapan filem SiN dan Si/SiO2.
● Beberapa mesin CVD perlu menggunakan H2 untuk penghidrogenan untuk meningkatkan mobiliti pembawa.
● NF3 ialah gas pembersih. Sebagai perbandingan: F2 sangat toksik, dan kesan rumah hijau SF6 lebih tinggi daripada NF3.
Dalam proses peranti semikonduktor, terdapat lebih banyak jenis filem nipis, sebagai tambahan kepada SiO2/Si/Sin biasa, terdapat juga W, Ti/Tin, Hfo2, Sic, dll.
Ini juga sebab mengapa terdapat banyak jenis prekursor untuk bahan canggih yang digunakan dalam industri semikonduktor, untuk membuat pelbagai jenis filem nipis.
1. Jenis CVD dan beberapa gas prekursor
2. Mekanisme asas CVD dan kualiti filem
CVD adalah konsep yang sangat umum dan boleh dibahagikan kepada banyak jenis. Yang biasa ialah:
● Pecvd: CVD Dipertingkat Plasma
● LPCVD: CVD tekanan rendah
● ALD: Pemendapan lapisan atom
● MOCVD: CVD logam-organik
Semasa proses CVD, ikatan kimia prekursor perlu dipecahkan sebelum tindak balas kimia.
Tenaga untuk memecahkan ikatan kimia berasal dari haba, jadi suhu ruang akan agak tinggi, yang tidak mesra dengan beberapa proses, seperti kaca substrat panel atau bahan PI skrin fleksibel. Oleh itu, dengan memasukkan tenaga lain (membentuk plasma, dan lain -lain) untuk mengurangkan suhu proses untuk memenuhi beberapa proses yang memerlukan suhu, anggaran terma juga akan dikurangkan.
Oleh itu, pemendapan PECVD a-Si:H/SiN/poly-Si digunakan secara meluas dalam industri paparan FPD. Prekursor dan filem CVD biasa:
Silikon polihablur/silikon kristal tunggal SiO2 SiN/SiON W/Ti WSi2 HfO2/SiC
Langkah -langkah mekanisme asas CVD:
1. Gas prekursor tindak balas memasuki ruang
2. Hasil perantaraan yang dihasilkan oleh tindak balas gas
3. Hasil perantaraan gas meresap ke permukaan substrat
4. Terjerap pada permukaan substrat dan meresap
5. Reaksi kimia berlaku pada permukaan substrat, pembentukan nukleasi/pulau/pembentukan filem
6. Hasil sampingan dinyahserap, vakum dipam keluar dan dinyahcas selepas memasuki penyental untuk rawatan
Seperti yang dinyatakan sebelum ini, keseluruhan proses termasuk pelbagai langkah seperti penyebaran/penjerapan/tindak balas. Kadar pembentukan filem keseluruhan dipengaruhi oleh banyak faktor, seperti suhu/tekanan/jenis gas reaksi/jenis substrat. Penyebaran mempunyai model penyebaran untuk ramalan, penjerapan mempunyai teori penjerapan, dan tindak balas kimia mempunyai teori kinetik tindak balas.
Dalam keseluruhan proses, langkah paling lambat menentukan keseluruhan kadar tindak balas. Ini sangat mirip dengan kaedah laluan kritikal pengurusan projek. Aliran aktiviti terpanjang menentukan tempoh projek terpendek. Tempoh ini boleh dipendekkan dengan memperuntukkan sumber untuk mengurangkan masa laluan ini. Begitu juga, CVD boleh mencari kesesakan utama yang mengehadkan kadar pembentukan filem dengan memahami keseluruhan proses, dan melaraskan tetapan parameter untuk mencapai kadar pembentukan filem yang ideal.
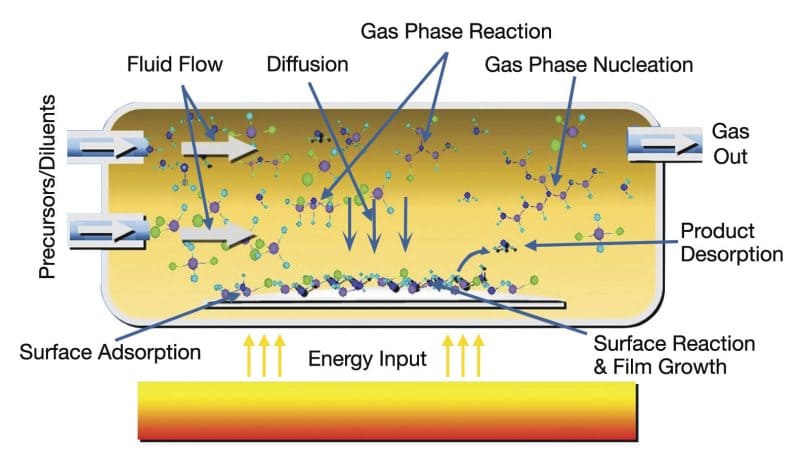
Sesetengah filem adalah rata, ada yang mengisi lubang, dan ada yang mengisi alur, dengan fungsi yang sangat berbeza. Mesin CVD komersial mesti memenuhi keperluan asas:
● Kapasiti pemprosesan mesin, kadar pemendapan
● Konsisten
● Tindak balas fasa gas tidak boleh menghasilkan zarah. Adalah sangat penting untuk tidak menghasilkan zarah dalam fasa gas.
Beberapa keperluan penilaian lain adalah seperti berikut:
● Liputan langkah yang baik
● Keupayaan untuk mengisi jurang nisbah aspek yang tinggi (konformaliti)
● Keseragaman ketebalan yang baik
● Ketulenan dan ketumpatan yang tinggi
● Tahap kesempurnaan struktur yang tinggi dengan tekanan filem yang rendah
● Sifat elektrik yang baik
● Lekatan yang sangat baik pada bahan substrat



+86-579-87223657


Jalan Wangda, Jalan Ziyang, Kaunti Wuyi, Bandar Jinhua, Wilayah Zhejiang, China
Hak Cipta © 2024 WuYi TianYao Advanced Material Tech.Co.,Ltd. Hak Cipta Terpelihara.
Links | Sitemap | RSS | XML | Dasar Privasi |
